Search Thermo Fisher Scientific

ELECTRICAL FAILURE ANALYSIS SYSTEMS
nProber IV System
Nanoprobing for electrical fault isolation and efficient TEM workflows to improve semiconductor failure analysis.
Join the Conversation
The Thermo Scientific nProber IV System is a high-performance scanning-electron-microscopy-based platform for the localization of transistor and metallization faults. It is our most advanced nanoprobing system to date, and the first to use the high-resolution LEEN2 SEM Column. The nProber IV System is specifically designed to increase the speed, accuracy, and output of your failure analysis (FA) workflow, where productivity is paramount.
The nProber IV System directly increases the success rate of transmission electron microscopy (TEM) analysis through precise fault localization and has proven to be both accurate and repeatable on even the most challenging process nodes. The automation and guided workflows of the nProber IV System improve lab productivity and allow your organization to focus on the output of your nanoprobing and TEM workflows while investing less in the operation of the system itself, thereby accelerating time-to-yield.
Improved process yield ramp with the nProber IV System
Time to yield is a significant focus for semiconductor fabs. The key to faster time to yield is the efficient identification of critical defects during process and device development. Nanoprobing plays a vital role in process yield ramp, localizing faults that cannot be found with other failure analysis techniques. Nanoprobing also delivers the precise localization required to ensure that the thin TEM samples will fully contain the fault, greatly improving the success rate of your TEM workflow. Finally, as nanoprobing localizes faults through accurate electrical characterization, TEM workflows that utilize nanoprobing combine TEM physical failure analysis with electrical fault signatures, helping to correlate process control improvements with device performance.
Thermo Fisher Scientific is the leader in supplying TEM workflows for process and device yield ramp, with widely adopted solutions for nanoprobing sample preparation, nanoprobing, TEM sample preparation and TEM physical failure analysis.
Leading edge transistor probing
nProber IV SteadFast Nanomanipulators and temperature-controlled probing environment combine to give the probe the necessary stability for working with leading-edge transistors.
High-resolution imaging of sensitive samples
The new LEEN2 Column of the nProber IV System enables low eV imaging and probing operation and includes an advanced control system that reduces sample dose by up to 30%. These advances allow the nProber IV System to provide accurate measurements of critical transistor parameters with minimal shifts from SEM imaging.
Guided operation and automation
The nProber IV System is equipped with eFast semi-automated guided workflows that take you through system operation from sample loading to electrical characterization. eFast Software automates the setup of the LEEN2 Column and controls key sub-systems ensuring consistent results in a multi-user production environment.
3D structures
The nProber IV Systems can be equipped with EBIRCH2 and EBAC to find critical faults in 3D interconnect structures down to ~100 Ω. EBIRCH2 can also be used to localize critical defects in FinFET transistors.
In addition, the nProber IV System can be equipped with a sub-stage that enables probes to be separated by many millimeters, essential for the isolation of faults in large 3D NAND structures.
Resistive gate faults
The nProber IV Systems can isolate resistive gate faults utilizing high-speed pulsed probing with rise times of less than 1 ns.
Automation
Our easyProbe Software automates key steps in the nProber IV workflow including: cleaning the probes, lowering the probes to the sample, and optimizing the electrical contact between the probes and the sample. easyProbe Software significantly reduces the training required to use the nProber IV System and allows for extended periods of unattended operation.
Automotive reliability
The optional Thermal Characterization Package supports the most recent automotive reliability standards. Samples temperatures can be controlled from -40°C to 150°C in order to isolate faults that are not detectable at ambient temperatures.
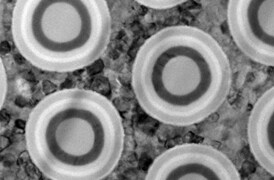
Desenvolvimento e localização de semicondutores
Microscopia eletrônica avançada, feixe de íon focalizado e técnicas analíticas associadas para identificar soluções viáveis e métodos de desenho para a fabricação de dispositivos semicondutores de alto desempenho.

Análise de falha de semicondutores
Estruturas de dispositivos semicondutores cada vez mais complexas resultam em mais locais onde defeitos que induzem falhas podem se ocultar. Nossos fluxos de trabalho de última geração o ajudam a localizar e caracterizar problemas elétricos sutis que afetam o rendimento, o desempenho e a confiabilidade.

Caracterização física e química
A demanda contínua dos consumidores impulsiona a criação de dispositivos eletrônicos menores, mais rápidos e mais baratos. Sua produção depende de instrumentos e fluxos de trabalho de alta produtividade que fazem imagens, analisam e caracterizam uma ampla gama de semicondutores e dispositivos de exibição.
Nanoamostragem
Conforme a complexidade do dispositivo aumenta, também aumenta o número de locais onde os defeitos podem ficar ocultos. A nanoamostragem fornece a localização precisa de falhas elétricas, o que é crítico para um fluxo de trabalho eficaz na análise de falhas na microscopia eletrônica de transmissão.
Preparação de amostra de dispositivos semicondutores
Os sistemas DualBeam da Thermo Scientific fornecem preparação precisa de amostra TEM para análise em escala atômica de dispositivos semicondutores. A automação e as tecnologias avançadas de aprendizado de máquina produzem amostras de alta qualidade, no local correto e com um baixo custo por amostra.
Remoção de camadas de dispositivo
Reduzir o tamanho do recurso, juntamente com um desenho e arquitetura avançados, resulta em uma análise de falha cada vez mais desafiadora para semicondutores. A remoção de camadas sem danos aos dispositivos é uma técnica crítica para a detecção de defeitos e falhas elétricas ocultos.
Nanoamostragem
Conforme a complexidade do dispositivo aumenta, também aumenta o número de locais onde os defeitos podem ficar ocultos. A nanoamostragem fornece a localização precisa de falhas elétricas, o que é crítico para um fluxo de trabalho eficaz na análise de falhas na microscopia eletrônica de transmissão.
Preparação de amostra de dispositivos semicondutores
Os sistemas DualBeam da Thermo Scientific fornecem preparação precisa de amostra TEM para análise em escala atômica de dispositivos semicondutores. A automação e as tecnologias avançadas de aprendizado de máquina produzem amostras de alta qualidade, no local correto e com um baixo custo por amostra.
Remoção de camadas de dispositivo
Reduzir o tamanho do recurso, juntamente com um desenho e arquitetura avançados, resulta em uma análise de falha cada vez mais desafiadora para semicondutores. A remoção de camadas sem danos aos dispositivos é uma técnica crítica para a detecção de defeitos e falhas elétricas ocultos.
Serviços de microscopia eletrônica
Para garantir o desempenho ideal do sistema, fornecemos acesso a uma rede de especialistas em serviços de campo, suporte técnico e peças de reposição certificadas.