Search Thermo Fisher Scientific
The continued trend of shrinking semiconductor features means that failure analysis is more challenging than ever before. Additionally, more advanced designs and complex 3D architectures result in an increasing number of wiring layers, more complex memory cells and more sensitive gate structures.
Due to this reduction in feature dimensions and increase in structure complexity, device delayering is becoming more and more important in detecting electrical faults (as well as other phenomena that contribute to device failure). While damage-free de-processing of single layers is critical, it can also be too time consuming for various industrial and R&D applications.
Thermo Fisher Scientific offers a unique combination of plasma FIB technology and proprietary Thermo Scientific Dx Chemistries, which enable automated and damage-free delayering of semiconductor devices, including 7/5-nm logic samples and 3D NAND memory devices. Automatic de-processing allows you to access buried information for advanced devices that would otherwise be unattainable.
Thermo Fisher Scientific's unique Plasma FIB delayering process complements the nProber IV and Hyperion II, delivering a robust nanoprobing and transistor characterization workflow. These instruments also provide advanced failure analysis of 3D packages, along with a wide range of other large-area focused-ion-beam (FIB) processing applications. See our product pages for more information.


Semiconductor Device Packaging
Advanced semiconductor device packaging requires new integration approaches and innovation in performance, power efficiency, area, and cost. See how Thermo Scientific failure analysis workflows provide fast, precise, and accurate time-to-data for device packaging development.
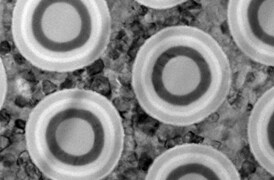
Semiconductor Pathfinding and Research
Advanced electron microscopy, focused ion beam, and associated analytical techniques for identifying viable solutions and design methods for the fabrication of high-performance semiconductor devices.

Yield Ramp and Metrology
We offer advanced analytical capabilities for defect analysis, metrology, and process control, designed to help increase productivity and improve yield across a range of semiconductor applications and devices.
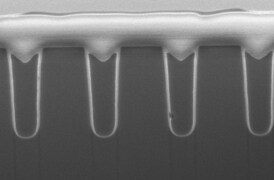
Power Semiconductor Device Analysis
Power devices pose unique challenges for localizing faults, primarily as a result of power device architecture and layout. Our power device analysis tools and workflows quickly pinpoint fault locations at operating conditions and provide precise, high-throughput analysis for characterization of materials, interfaces and device structures.

Display Module Failure Analysis
Evolving display technologies aim to improve display quality and light conversion efficiency to support applications in different industry sectors, while continuing to reduce production costs. Our process metrology, failure analysis and research and development solutions help display companies solve these challenges.

Physical and Chemical Characterization
Ongoing consumer demand drives the creation of smaller, faster, and cheaper electronic devices. Their production relies on high-productivity instruments and workflows that image, analyze, and characterize a broad range of semiconductor and display devices.
Semiconductor Materials and Device Characterization
As semiconductor devices shrink and become more complex, new designs and structures are needed. High-productivity 3D analysis workflows can shorten device development time, maximize yield, and ensure that devices meet the future needs of the industry.
Electron microscopy services for
semiconductors
To ensure optimal system performance, we provide you access to a world-class network of field service experts, technical support, and certified spare parts.









