Search Thermo Fisher Scientific
Semiconductor Analysis
Optical Fault Isolation
Semiconductor fault isolation techniques that enable failure analysis labs to localize electrical faults in devices.
Join the Conversation
Troubleshooting semiconductor device failure is critical for improving manufacturing yield, reducing costs, and minimizing overall end-of-line test failures. However, isolating faults and defects (e.g. opens, metal shorts, and leakages) in the failure analysis workflow is becoming more challenging due to increasingly complex semiconductor designs.
Optical fault isolation (OFI) is a type of electrical failure analysis that makes use of a variety of optical techniques (photon-emission, static laser stimulation, etc.) to detect the causes of device failure.
This can include both static and dynamic OFI:
| Static OFI techniques | Dynamic OFI techniques |
|---|---|
| Optical beam Induced resistance change (OBIRCH) | Laser voltage imaging (LVI) |
| Optical beam induced current (OBIC) | Laser Voltage Probing (LVP) |
| Light induced voltage alteration (LIVA) | Laser voltage tracing (LVT) |
| Thermally induced voltage alteration (TIVA) | Laser-assisted device alteration (LADA) |
| Static photon emission (PEM) | Soft defect localization (SDL) |
| Dynamic photon emission (PEM) |
Broadly, these techniques allow the user to analyze the performance of electrically active devices and locate critical defects that cause a device to fail. Understanding these defects, and then eliminating them from the manufacturing process, is crucial if modern fabs are to operate at high yield and profitability.
Thermo Fisher Scientific offers a variety of optical fault isolation systems as part of the Meridian product line. This includes all of the above OFI techniques, encompassing systems for both photon emission and laser stimulation applications. The Meridian product line consists of cost-effective, high-sensitivity solutions for localizing electrical failures in semiconductor devices, and is especially powerful when combined with other analysis workflows and solutions from Thermo Fisher Scientific's portfolio. Click through to the appropriate product pages below for more information.
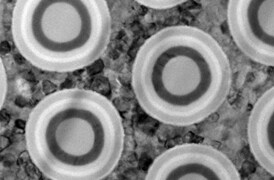
Desenvolvimento e localização de semicondutores
Microscopia eletrônica avançada, feixe de íon focalizado e técnicas analíticas associadas para identificar soluções viáveis e métodos de desenho para a fabricação de dispositivos semicondutores de alto desempenho.

Rampa de escoamento e metrologia
Oferecemos recursos analíticos avançados para análise de defeitos, metrologia e controle de processos projetados para ajudar a aumentar a produtividade e melhorar o rendimento em uma variedade de aplicações e dispositivos semicondutores.

Análise de falha de semicondutores
Estruturas de dispositivos semicondutores cada vez mais complexas resultam em mais locais onde defeitos que induzem falhas podem se ocultar. Nossos fluxos de trabalho de última geração o ajudam a localizar e caracterizar problemas elétricos sutis que afetam o rendimento, o desempenho e a confiabilidade.

Caracterização física e química
A demanda contínua dos consumidores impulsiona a criação de dispositivos eletrônicos menores, mais rápidos e mais baratos. Sua produção depende de instrumentos e fluxos de trabalho de alta produtividade que fazem imagens, analisam e caracterizam uma ampla gama de semicondutores e dispositivos de exibição.

Qualificação de semicondutores ESD
Cada plano de controle de descarga eletrostática (ESD) é necessário para identificar dispositivos sensíveis à ESD. Oferecemos um conjunto completo de sistemas de teste para ajudar com os requisitos de qualificação do seu dispositivo.
Materiais semicondutores e caracterização de dispositivos
À medida que os dispositivos semicondutores encolhem e se tornam mais complexos, há a necessidade de novos desenhos e estruturas. Os fluxos de trabalho de análise 3D de alta produtividade podem reduzir o tempo de desenvolvimento de dispositivos, maximizar o rendimento e garantir que os dispositivos atendam às necessidades futuras do setor.
Serviços de microscopia eletrônica para
semicondutores
Para garantir o desempenho ideal do sistema, fornecemos acesso a uma rede de especialistas em serviços de campo, suporte técnico e peças de reposição certificadas.









