Search Thermo Fisher Scientific
Focused ion beam scanning electron microscopy
The Thermo Scientific Scios 2 DualBeam is an ultra-high-resolution analytical focused ion beam scanning electron microscopy (FIB-SEM) system that provides outstanding sample preparation and 3D characterization performance for a wide range of samples, including magnetic and non-conductive materials. With innovative features designed to increase throughput, precision, and ease of use, the Scios 2 DualBeam is an ideal solution to meet the needs of scientists and engineers in advanced research and analysis across academic, governmental, and industrial research environments.
Subsurface characterization
Subsurface or three-dimensional characterization is often required to better understand the structure and properties of a sample. The Scios 2 DualBeam, with optional Thermo Scientific Auto Slice & View 4 (AS&V4) Software, allows for high-quality, fully automated acquisition of multi-modal 3D datasets, including backscattered electron (BSE) imaging for maximum materials contrast, energy-dispersive spectroscopy (EDS) for compositional information, and electron backscatter diffraction (EBSD) for microstructural and crystallographic information. Combined with Thermo Scientific Avizo Software, the Scios 2 DualBeam delivers a unique workflow solution for high-resolution, advanced 3D characterization and analysis at the nanometer scale.
Backscattered electron and secondary electron imaging
The innovative NICol electron column provides the foundation of the system’s high-resolution imaging and detection capabilities. It offers excellent nanoscale details, with a wide range of working conditions, whether operating at 30 keV in STEM mode (to access structural information) or at lower energies (to obtain charge-free, detailed surface information). With its unique in-lens Thermo Scientific Trinity Detection System, the Scios 2 DualBeam is designed for simultaneous acquisition of angular and energy-selective secondary electron (SE) and BSE imaging. Fast access to detailed nanoscale information is possible not only top-down, but also on tilted specimens or cross-sections. Optional below-the-lens detectors and an electron-beam-deceleration mode ensure fast and easy simultaneous collection of all signals, revealing the smallest features in a material surface or cross-section. Fast, accurate, and reproducible results are obtained thanks to the unique NICol column design with full auto alignments.
TEM sample preparation
Scientists and engineers constantly face new challenges that require highly localized characterization of increasingly complex samples with ever smaller features. The latest technological innovations of the Scios 2 DualBeam, in combination with the optional, easy-to-use, comprehensive Thermo Scientific AutoTEM 4 Software and Thermo Fisher Scientific’s application expertise, allow for fast and easy preparation of site-specific high-resolution S/TEM samples for a wide range of materials. In order to achieve high-quality results, final polishing with low-energy ions is required to minimize surface damage on the sample. The Thermo Scientific Sidewinder HT Focused Ion Beam (FIB) column not only delivers high-resolution imaging and milling at high voltages but also offers good low-voltage performance, enabling the creation of high-quality TEM lamella.
Fast and easy preparation
High-quality, site-specific, TEM and atom probe samples using the Sidewinder HT ion column.
Ultra-high resolution imaging
Using the Thermo Scientific NICol Electron Column with best-in-class performance on the widest range of samples, including magnetic and nonconductive materials.
The most complete sample information
With sharp, refined, and charge-free contrast obtained from a variety of integrated in-column and below-the-lens detectors.
High-quality, multi-modal subsurface and 3D information
Access the high-quality, multi-modal subsurface and 3D information with precise targeting of the region of interest using optional AS&V4 Software.
Precise sample navigation
Tailored to individual application needs thanks to the high flexibility 110 mm stage and in-chamber Thermo Scientific Nav-Cam Camera.
Artifact-free imaging and patterning
With dedicated modes such as DCFI, drift suppression and Thermo Scientific SmartScan Modes.
Optimize your solution
Meet specific application requirements thanks to flexible DualBeam configuration, including optional low-vacuum mode with up to 500 Pa chamber pressure.
| Electron beam resolution |
|
| Electron beam parameter space |
|
| Ion optics |
|
| Detectors |
|
| Stage and sample | Flexible 5-axis motorized stage:
|
* Available as an option, configuration dependent
Introducing the Thermo Scientific Scios 2 FIB-SEM. Learn how this ultra-high resolution analytical system provides outstanding sample preparation and 3D characterization performance for the widest range of samples, including magnetic and nonconductive materials.
Webinar: Advanced DualBeam automation for every need
Register for our exclusive webinar to learn how easy it has become to automate daily routine tasks on your DualBeam instrument using our Python-based AutoScript 4 API. Automation can also increase throughput, reproducibility and ease of use, quicken time to data and boost efficiency.
Introducing the Thermo Scientific Scios 2 FIB-SEM. Learn how this ultra-high resolution analytical system provides outstanding sample preparation and 3D characterization performance for the widest range of samples, including magnetic and nonconductive materials.
Webinar: Advanced DualBeam automation for every need
Register for our exclusive webinar to learn how easy it has become to automate daily routine tasks on your DualBeam instrument using our Python-based AutoScript 4 API. Automation can also increase throughput, reproducibility and ease of use, quicken time to data and boost efficiency.
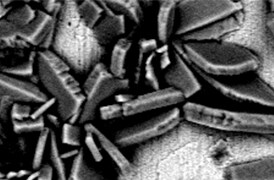
Controle de processo
A indústria moderna exige alta produtividade com qualidade superior, um equilíbrio mantido por meio de um controle de processo robusto. As ferramentas SEM e TEM com software de automação dedicado proporcionam informações rápidas e em várias escalas para monitoramento e aprimoramento de processos.

Controle de qualidade
O controle de qualidade e a garantia de qualidade são essenciais na indústria moderna. Oferecemos uma gama de ferramentas de microscopia eletrônica e espectroscopia para análises multidimensionais e multimodais de defeitos, permitindo que você tome decisões confiáveis e informadas para controle e melhoria de processos.

Pesquisa de materiais fundamentais
Novos materiais são investigados em escalas cada vez menores para o máximo controle de suas propriedades físicas e químicas. A microscopia eletrônica fornece aos pesquisadores percepções importantes sobre uma ampla variedade de características materiais em escala micro a nano.
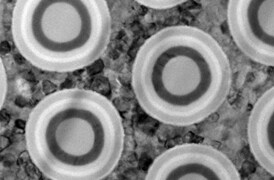
Desenvolvimento e localização de semicondutores
Microscopia eletrônica avançada, feixe de íon focalizado e técnicas analíticas associadas para identificar soluções viáveis e métodos de desenho para a fabricação de dispositivos semicondutores de alto desempenho.

Rampa de escoamento e metrologia
Oferecemos recursos analíticos avançados para análise de defeitos, metrologia e controle de processos projetados para ajudar a aumentar a produtividade e melhorar o rendimento em uma variedade de aplicações e dispositivos semicondutores.

Análise de falha de semicondutores
Estruturas de dispositivos semicondutores cada vez mais complexas resultam em mais locais onde defeitos que induzem falhas podem se ocultar. Nossos fluxos de trabalho de última geração o ajudam a localizar e caracterizar problemas elétricos sutis que afetam o rendimento, o desempenho e a confiabilidade.

Caracterização física e química
A demanda contínua dos consumidores impulsiona a criação de dispositivos eletrônicos menores, mais rápidos e mais baratos. Sua produção depende de instrumentos e fluxos de trabalho de alta produtividade que fazem imagens, analisam e caracterizam uma ampla gama de semicondutores e dispositivos de exibição.

Preparação de amostra (S)TEM
Os microscópios DualBeam permitem a preparação de amostras ultrafinas e de alta qualidade para análise de (S)TEM. Graças à automação avançada, os usuários com qualquer nível de experiência podem obter resultados de nível especializado para uma ampla gama de materiais.

Caracterização de materiais 3D
O desenvolvimento de materiais muitas vezes requer caracterização 3D em várias escalas. Os instrumentos DualBeam permitem a secção em série de grandes volumes e a subsequente geração de imagens SEM nanométricas, que podem ser processadas em reconstruções 3D de alta qualidade da amostra.

Preparação de amostra APT
A tomografia por sonda atômica (APT) fornece análise de composição de resolução atômica 3D de materiais. A microscopia de feixe de íons focalizados (FIB) é uma técnica essencial para a preparação de amostra de alta qualidade, orientada e específica de local para a caracterização APT.

Corte transversal
O corte transversal fornece dados adicionais ao revelar informações de subsuperfície. Os instrumentos DualBeam apresentam excelentes colunas de feixe de íons focalizados para corte transversal de alta qualidade. A automação permite realizar o processamento autônomo de amostras com alta produtividade.

Experimentação in situ
A observação direta e em tempo real de alterações microestruturais com a microscopia eletrônica é necessária para entender os princípios subjacentes de processos dinâmicos, como recristalização, crescimento de grãos e transformação de fases durante o aquecimento, o resfriamento e a umidificação.

Análise em várias escalas
Os materiais novos precisam ser analisados em resolução cada vez maior, mantendo o contexto maior da amostra. A análise em várias escalas permite correlacionar várias ferramentas e modalidades de geração de imagens, como a microTC de raios X, DualBeam, laser PFIB, SEM e TEM.
Preparação de amostra de dispositivos semicondutores
Os sistemas DualBeam da Thermo Scientific fornecem preparação precisa de amostra TEM para análise em escala atômica de dispositivos semicondutores. A automação e as tecnologias avançadas de aprendizado de máquina produzem amostras de alta qualidade, no local correto e com um baixo custo por amostra.

Preparação de amostra (S)TEM
Os microscópios DualBeam permitem a preparação de amostras ultrafinas e de alta qualidade para análise de (S)TEM. Graças à automação avançada, os usuários com qualquer nível de experiência podem obter resultados de nível especializado para uma ampla gama de materiais.

Caracterização de materiais 3D
O desenvolvimento de materiais muitas vezes requer caracterização 3D em várias escalas. Os instrumentos DualBeam permitem a secção em série de grandes volumes e a subsequente geração de imagens SEM nanométricas, que podem ser processadas em reconstruções 3D de alta qualidade da amostra.

Preparação de amostra APT
A tomografia por sonda atômica (APT) fornece análise de composição de resolução atômica 3D de materiais. A microscopia de feixe de íons focalizados (FIB) é uma técnica essencial para a preparação de amostra de alta qualidade, orientada e específica de local para a caracterização APT.

Corte transversal
O corte transversal fornece dados adicionais ao revelar informações de subsuperfície. Os instrumentos DualBeam apresentam excelentes colunas de feixe de íons focalizados para corte transversal de alta qualidade. A automação permite realizar o processamento autônomo de amostras com alta produtividade.

Experimentação in situ
A observação direta e em tempo real de alterações microestruturais com a microscopia eletrônica é necessária para entender os princípios subjacentes de processos dinâmicos, como recristalização, crescimento de grãos e transformação de fases durante o aquecimento, o resfriamento e a umidificação.

Análise em várias escalas
Os materiais novos precisam ser analisados em resolução cada vez maior, mantendo o contexto maior da amostra. A análise em várias escalas permite correlacionar várias ferramentas e modalidades de geração de imagens, como a microTC de raios X, DualBeam, laser PFIB, SEM e TEM.
Preparação de amostra de dispositivos semicondutores
Os sistemas DualBeam da Thermo Scientific fornecem preparação precisa de amostra TEM para análise em escala atômica de dispositivos semicondutores. A automação e as tecnologias avançadas de aprendizado de máquina produzem amostras de alta qualidade, no local correto e com um baixo custo por amostra.
Serviços de microscopia eletrônica
Para garantir o desempenho ideal do sistema, fornecemos acesso a uma rede de especialistas em serviços de campo, suporte técnico e peças de reposição certificadas.


