Search Thermo Fisher Scientific

DualBeam Microscopes
Helios 5 PFIB DualBeam
Plasma focused ion beam scanning electron microscope for TEM sample preparation including 3D characterization, cross-sectioning and micromachining.
Join the Conversation
Plasma focused ion beam instrument
Helios 5 Plasma FIB DualBeam FiB SEM Microscope
The Thermo Scientific Helios 5 Plasma FIB (PFIB) DualBeam (focused ion beam scanning electron microscope, or FIB-SEM) delivers unmatched capabilities for materials science and semiconductor applications. For materials science researchers, the Helios 5 PFIB DualBeam provides large-volume 3D characterization, gallium-free sample preparation, and precise micromachining. For manufacturers of semiconductor devices, advanced packaging technology, and display devices, the Helios 5 PFIB DualBeam delivers damage-free, large-area de-processing, fast sample preparation, and high-fidelity failure analysis.
Gallium-free STEM and TEM sample preparation
High-quality, gallium-free TEM and APT sample preparation thanks to the new PFIB column enabling 500 V Xe+ final polishing and delivering superior performance at all operating conditions.
Advanced automation
Fastest and easiest, automated, multisite in situ and ex situ TEM sample preparation and cross-sectioning using optional AutoTEM 5 Software.
Next-generation 2.5 μA xenon plasma FIB column
High throughput and quality statistically relevant 3D characterization, cross-sectioning and micromachining using next generation 2.5 μA Xenon Plasma FIB column (PFIB).
Multi-modal subsurface and 3D information
Access high-quality, multi-modal subsurface and 3D information with precise targeting of the region of interest using optional Auto Slice & View 4 (AS&V4) Software.
Sub-nanometer performance at low energies
Reveal the finest details using best-in-class Elstar Electron Column with high-current UC+ monochromator technology, enabling sub-nanometer performance at low energies.
Complete sample information
The most complete sample information with sharp, refined, and charge-free contrast obtained from up to six integrated in-column and below-the-lens detectors.
Advanced capabilities
Most advanced capabilities for electron and ion beam induced deposition and etching on FIB/SEM systems with optional Thermo Scientific MultiChem or GIS Gas Delivery Systems.
Artifact-free imaging
Artifact-free imaging based on integrated sample cleanliness management and dedicated imaging modes such as SmartScan™ and DCFI Modes.
Short time to nanoscale information
Shortest time to nanoscale information for users with any experience level with SmartAlign and FLASH technologies.
Precise sample navigation
Precise sample navigation tailored to individual application needs thanks to the high stability and accuracy of 150 mm Piezo stage and optional in-chamber Nav-Cam.
Semiconductor device deprocessing
The combination of Dx chemistry and the plasma FIB beam provides a unique, site-specific, deprocessing and failure analysis workflow for advanced logic, 3D NAND, and DRAM.
High-speed, large-area cross-sectioning
The next-generation 2.5 μA xenon PFIB column provides high-throughput, high-quality, statistically relevant 3D characterization, cross-sectioning, and micromachining.
TEM sample preparation
Perform high-quality, single layer planar and cross-sectional, top-down, and inverted TEM sample preparation by combining PFIB deprocessing and Thermo Scientific guided workflows.
Sub-nanometer, low-energy SEM performance
Reveal the finest details using the best-in-class Elstar Electron Column with high-current UC+ monochromator technology, enabling sub-nanometer performance at low energies.
Advanced automation
Carry out automated deprocessing with end pointing. SmartAlign and FLASH technologies make for a short time to nanoscale information for users with any experience level.
Complete sample information
Obtain the most complete sample information with sharp, refined, and charge-free contrast from up to six integrated in-column and below-the-lens detectors.
Artifact-free imaging
Obtain artifact-free imaging with in situ auto rocking polish and dedicated imaging modes such as SmartScan and DCFI modes.
Precise sample navigation
Experience precise sample navigation tailored to individual application needs from the flexible 5-axis motorized stage configuration and ultra-high-resolution stage options.
| Helios 5 PFIB CXe DualBeam | Helios 5 PFIB UXe DualBeam | |
| Electron optics |
| |
| Electron beam resolution |
| |
| Electron beam parameter space |
| |
| Ion optics |
| |
| Detectors |
| |
| Stage and sample | Flexible 5-axis motorized stage:
| High-precision, 5-axis motorized stage with XYR axis, piezo-driven
|
*Available as an option, configuration dependent
| Helios 5 PFIB CXe DualBeam | Helios 5 PFIB UXe DualBeam | Helios 5 PFIB HXe DualBeam | |
| Application | Advanced packaging and display R&D and failure analysis | Advanced memory failure analysis | Advanced logic failure analysis |
| Electron optics |
| ||
| Electron beam resolution |
| ||
| Ion optics |
| ||
| Stage and sample | Flexible 5-axis motorized stage:
| High-precision, 5-axis motorized stage with XYR axis, piezo-driven
| 5-axis, all-Piezo-driven UHR stage
|



Thermo Fisher Scientific PFA Demo Days
To support semiconductor manufacturing needs, Thermo Fisher Scientific continues to bring new capabilities to our industry-leading failure analysis, metrology and characterization solutions.
In our Thermo Fisher Scientific PFA Demo Days, we showcase our latest innovations for sample preparation and FinFET logic circuit delayering.
Advanced DualBeam automation for every need
Register for our exclusive webinar to learn how easy it has become to automate daily routine tasks on your DualBeam instrument using our Python-based AutoScript 4 API. Automation can also increase throughput, reproducibility and ease of use, quicken time to data and boost efficiency.
The Thermo Scientific Helios DualBeam
Interview - Laser PFIB use case from Manchester University
Interview - Laser PFIB use case from ScopeM



Thermo Fisher Scientific PFA Demo Days
To support semiconductor manufacturing needs, Thermo Fisher Scientific continues to bring new capabilities to our industry-leading failure analysis, metrology and characterization solutions.
In our Thermo Fisher Scientific PFA Demo Days, we showcase our latest innovations for sample preparation and FinFET logic circuit delayering.
Advanced DualBeam automation for every need
Register for our exclusive webinar to learn how easy it has become to automate daily routine tasks on your DualBeam instrument using our Python-based AutoScript 4 API. Automation can also increase throughput, reproducibility and ease of use, quicken time to data and boost efficiency.
The Thermo Scientific Helios DualBeam
Interview - Laser PFIB use case from Manchester University
Interview - Laser PFIB use case from ScopeM

Pesquisa de materiais fundamentais
Novos materiais são investigados em escalas cada vez menores para o máximo controle de suas propriedades físicas e químicas. A microscopia eletrônica fornece aos pesquisadores percepções importantes sobre uma ampla variedade de características materiais em escala micro a nano.
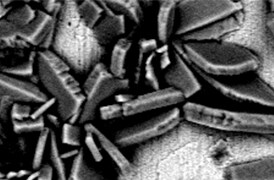
Controle de processo
A indústria moderna exige alta produtividade com qualidade superior, um equilíbrio mantido por meio de um controle de processo robusto. As ferramentas SEM e TEM com software de automação dedicado proporcionam informações rápidas e em várias escalas para monitoramento e aprimoramento de processos.

Controle de qualidade
O controle de qualidade e a garantia de qualidade são essenciais na indústria moderna. Oferecemos uma gama de ferramentas de microscopia eletrônica e espectroscopia para análises multidimensionais e multimodais de defeitos, permitindo que você tome decisões confiáveis e informadas para controle e melhoria de processos.

Análise de falha de semicondutores
Estruturas de dispositivos semicondutores cada vez mais complexas resultam em mais locais onde defeitos que induzem falhas podem se ocultar. Nossos fluxos de trabalho de última geração o ajudam a localizar e caracterizar problemas elétricos sutis que afetam o rendimento, o desempenho e a confiabilidade.

Caracterização física e química
A demanda contínua dos consumidores impulsiona a criação de dispositivos eletrônicos menores, mais rápidos e mais baratos. Sua produção depende de instrumentos e fluxos de trabalho de alta produtividade que fazem imagens, analisam e caracterizam uma ampla gama de semicondutores e dispositivos de exibição.
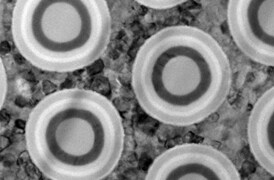
Desenvolvimento e localização de semicondutores
Microscopia eletrônica avançada, feixe de íon focalizado e técnicas analíticas associadas para identificar soluções viáveis e métodos de desenho para a fabricação de dispositivos semicondutores de alto desempenho.

Preparação de amostra (S)TEM
Os microscópios DualBeam permitem a preparação de amostras ultrafinas e de alta qualidade para análise de (S)TEM. Graças à automação avançada, os usuários com qualquer nível de experiência podem obter resultados de nível especializado para uma ampla gama de materiais.

Preparação de amostra APT
A tomografia por sonda atômica (APT) fornece análise de composição de resolução atômica 3D de materiais. A microscopia de feixe de íons focalizados (FIB) é uma técnica essencial para a preparação de amostra de alta qualidade, orientada e específica de local para a caracterização APT.

Experimentação in situ
A observação direta e em tempo real de alterações microestruturais com a microscopia eletrônica é necessária para entender os princípios subjacentes de processos dinâmicos, como recristalização, crescimento de grãos e transformação de fases durante o aquecimento, o resfriamento e a umidificação.

Análise em várias escalas
Os materiais novos precisam ser analisados em resolução cada vez maior, mantendo o contexto maior da amostra. A análise em várias escalas permite correlacionar várias ferramentas e modalidades de geração de imagens, como a microTC de raios X, DualBeam, laser PFIB, SEM e TEM.

Caracterização de materiais 3D
O desenvolvimento de materiais muitas vezes requer caracterização 3D em várias escalas. Os instrumentos DualBeam permitem a secção em série de grandes volumes e a subsequente geração de imagens SEM nanométricas, que podem ser processadas em reconstruções 3D de alta qualidade da amostra.

Corte transversal
O corte transversal fornece dados adicionais ao revelar informações de subsuperfície. Os instrumentos DualBeam apresentam excelentes colunas de feixe de íons focalizados para corte transversal de alta qualidade. A automação permite realizar o processamento autônomo de amostras com alta produtividade.
Ablação a laser de semicondutores
A ablação a laser fornece desbaste de alto rendimento de dispositivos semicondutores para aquisição de imagens e análise com microscopia eletrônica e, ao mesmo tempo, preserva a integridade da amostra. Acesse dados 3D de grande volume e otimize as condições de desbaste com melhor adequação ao tipo da amostra.
Nanoamostragem
Conforme a complexidade do dispositivo aumenta, também aumenta o número de locais onde os defeitos podem ficar ocultos. A nanoamostragem fornece a localização precisa de falhas elétricas, o que é crítico para um fluxo de trabalho eficaz na análise de falhas na microscopia eletrônica de transmissão.
Remoção de camadas de dispositivo
Reduzir o tamanho do recurso, juntamente com um desenho e arquitetura avançados, resulta em uma análise de falha cada vez mais desafiadora para semicondutores. A remoção de camadas sem danos aos dispositivos é uma técnica crítica para a detecção de defeitos e falhas elétricas ocultos.

Preparação de amostra (S)TEM
Os microscópios DualBeam permitem a preparação de amostras ultrafinas e de alta qualidade para análise de (S)TEM. Graças à automação avançada, os usuários com qualquer nível de experiência podem obter resultados de nível especializado para uma ampla gama de materiais.

Preparação de amostra APT
A tomografia por sonda atômica (APT) fornece análise de composição de resolução atômica 3D de materiais. A microscopia de feixe de íons focalizados (FIB) é uma técnica essencial para a preparação de amostra de alta qualidade, orientada e específica de local para a caracterização APT.

Experimentação in situ
A observação direta e em tempo real de alterações microestruturais com a microscopia eletrônica é necessária para entender os princípios subjacentes de processos dinâmicos, como recristalização, crescimento de grãos e transformação de fases durante o aquecimento, o resfriamento e a umidificação.

Análise em várias escalas
Os materiais novos precisam ser analisados em resolução cada vez maior, mantendo o contexto maior da amostra. A análise em várias escalas permite correlacionar várias ferramentas e modalidades de geração de imagens, como a microTC de raios X, DualBeam, laser PFIB, SEM e TEM.

Caracterização de materiais 3D
O desenvolvimento de materiais muitas vezes requer caracterização 3D em várias escalas. Os instrumentos DualBeam permitem a secção em série de grandes volumes e a subsequente geração de imagens SEM nanométricas, que podem ser processadas em reconstruções 3D de alta qualidade da amostra.

Corte transversal
O corte transversal fornece dados adicionais ao revelar informações de subsuperfície. Os instrumentos DualBeam apresentam excelentes colunas de feixe de íons focalizados para corte transversal de alta qualidade. A automação permite realizar o processamento autônomo de amostras com alta produtividade.
Ablação a laser de semicondutores
A ablação a laser fornece desbaste de alto rendimento de dispositivos semicondutores para aquisição de imagens e análise com microscopia eletrônica e, ao mesmo tempo, preserva a integridade da amostra. Acesse dados 3D de grande volume e otimize as condições de desbaste com melhor adequação ao tipo da amostra.
Nanoamostragem
Conforme a complexidade do dispositivo aumenta, também aumenta o número de locais onde os defeitos podem ficar ocultos. A nanoamostragem fornece a localização precisa de falhas elétricas, o que é crítico para um fluxo de trabalho eficaz na análise de falhas na microscopia eletrônica de transmissão.
Remoção de camadas de dispositivo
Reduzir o tamanho do recurso, juntamente com um desenho e arquitetura avançados, resulta em uma análise de falha cada vez mais desafiadora para semicondutores. A remoção de camadas sem danos aos dispositivos é uma técnica crítica para a detecção de defeitos e falhas elétricas ocultos.
Serviços de microscopia eletrônica
Para garantir o desempenho ideal do sistema, fornecemos acesso a uma rede de especialistas em serviços de campo, suporte técnico e peças de reposição certificadas.