Search Thermo Fisher Scientific

DualBeam Microscopes
Helios 5 DualBeam
Sample preparation for TEM and STEM imaging or atom probe tomography. Easy to use with advanced automation. Capable of high quality subsurface 3D characterization.
Join the Conversation
FIB sample preparation
The new Thermo Scientific Helios 5 DualBeam builds on the high-performance imaging and analysis capabilities of the industry-leading Helios DualBeam family. It is carefully designed to meet the needs of materials science researchers and engineers for a wide range of focused ion beam scanning electron microscopy (FIB-SEM) use cases – even on the most challenging samples.
The Helios 5 DualBeam redefines the standard in high-resolution imaging with high materials contrast; fast, easy, and precise high-quality sample preparation for (S)TEM imaging and atom probe tomography (APT) as well as the high-quality subsurface and 3D characterization. Building on the proven capabilities of the Helios DualBeam family, additional advancements to the new Helios 5 DualBeam were designed to ensure the system is optimized for a variety of manual or automated workflows. Those improvements include:
- Greater ease-of-use: The Helios 5 DualBeam is the most accessible DualBeam for users of all experience levels. Operator training may be reduced from months to days and the system design is helping all operators to achieve consistent, repeatable results on a wide variety of advanced applications.
- Increased productivity: Advanced automation capabilities, increased robustness and stability enhancements in the Helios 5 DualBeam and Thermo Scientific AutoTEM 5 software can significantly increase the sample preparation throughput by allowing unattended and even overnight operation.
- Improved time to results: The Helios 5 DualBeam now includes FLASH, a new concept of tuning the image. With conventional microscopes, each time an operator needs to acquire an image, the microscope has to be carefully tuned by iterative alignments. With the Helios 5 DualBeam, a simple gesture across the screen will activate FLASH, which automatically adjusts these parameters. The automatic adjustments can significantly improve throughput, data quality, and simplify the acquisition of high-quality images.
TEM sample preparation
The Thermo Scientific Helios 5 DualBeam is part of the fifth generation of the industry-leading Helios DualBeam family. It is carefully designed to meet the needs of scientists and engineers, combining the innovative Elstar electron column for extreme high-resolution imaging and the high materials contrast with the superior Thermo Scientific Tomahawk Ion Column for the fast, easy, and precise high-quality sample preparation. In addition to the advanced electron and ion optics, the Helios 5 DualBeam incorporates a suite of state of-the-art technologies that enables simple and consistent high-resolution (S)TEM and atom probe tomography (APT) sample preparation, as well as the high-quality subsurface and 3D characterization, even on the most challenging samples.
High-quality sample preparation
Site-specific sample preparation for (S)TEM and APT analysis using the high-throughput Thermo Scientific Tomahawk Ion Column or the Thermo Scientific Phoenix Ion Column with unmatched low-voltage performance.
Fully automated
Fast and easy, fully automated, unattended, multi-site in situ and ex situ TEM sample preparation and cross-sectioning using optional AutoTEM 5 Software.
Shortest time to nanoscale information
For users with any experience level using best-in-class Thermo Scientific Elstar Electron Column featuring Thermo Scientific SmartAlign and FLASH technologies.
Next-generation UC+ monochromator technology
Reveal the finest details with the next-generation UC+ monochromator technology with higher current, enabling sub-nanometer performance at low energies.
Complete sample information
Sharp, refined and charge-free contrast obtained from up to six integrated in-column and below-the-lens detectors.
3D analysis
The high-quality, multi-modal subsurface and 3D information with the precise region-of-interest targeting using optional Thermo Scientific Auto Slice & View 4 (AS&V4) Software.
Rapid nanoprototyping
Fast, accurate and precise milling and deposition of complex structures with critical dimensions of less than 10 nm.
Precise sample navigation
Tailored to individual application needs thanks to the high stability and accuracy of the 150-mm piezo stage or the flexibility of the 110-mm stage, as well as the in-chamber Thermo Scientific Nav-Cam Camera.
Artifact-free imaging
Based on integrated sample cleanliness management and dedicated imaging modes such as DCFI and SmartScan Modes.
STEM imaging
The Thermo Scientific Helios 5 FX configuration offers a high productivity workflow with its unique, in-situ, 3Å resolution STEM capability.
To view the specifications of the Helios 5 HX DualBeam and Helios 5 FX DualBeam, download the datasheet found in the documents section.
Helios 5 DualBeam specifications for the semiconductor industry
| Helios 5 CX | Helios 5 HP | Helios 5 UX | Helios 5 HX | Helios 5 FX | ||
| Workhorse preparation and XHR SEM imaging | Ultimate sample preparation (TEM lamellae, APT) | Angstrom-scale STEM imaging and sample preparation | ||||
| SEM | Resolution | 20 eV – 30 keV | 20 eV – 30 keV | |||
| Landing energy | 0.6 nm @ 15 keV 1.0 nm @ 1 keV | 0.6 nm @ 2 keV 0.7 nm @ 1 keV 1.0 nm @ 500 eV | ||||
| STEM | Resolution @ 30 keV | 0.7 nm | 0.6 nm | 0.3 nm | ||
| FIB preparation processes | Max material removal | 100 nA | 100 nA | 65 nA | ||
| Optimal final polish | 2 kV | 500 V | ||||
| TEM sample preparation | Sample thickness | 50 nm | 15 nm | 7 nm | ||
| Automation | No | Yes | Yes | |||
| Sample handling | Travel | 110 x 110 x 65 mm | 100 x 100 x 65 mm | 150 x 150 x 10 mm | 100 x 100 x 20 mm | 100 x 100 x 20 mm + 5 axis (S)TEM Compustage |
| Loadlock | Manual Quickloader | Automated | Manual Quickloader | Automated | Auto + Auto insert/extract STEM rod | |
Helios 5 DualBeam specifications for the materials science
| Helios 5 CX | Helios 5 UC | Helios 5 UX | ||
| Ion optics | Tomahawk HT Ion Column with superior high-current performance | Phoenix Ion Column with superior high-current and low-voltage performance | ||
| Ion beam current range | 1 pA – 100 nA | 1 pA – 65 nA | ||
| Accelerating voltage range | 500 V – 30 kV | 500 V – 30 kV | ||
| Max. horizontal field width | 0.9 mm at beam coincidence point | 0.7 mm at beam coincidence point | ||
| Minimum source lifetime | 1,000 hours | 1,000 hours | ||
| Two-stage differential pumping Time-of-flight (TOF) correction 15-position aperture strip | Two-stage differential pumping Time-of-flight (TOF) correction 15-position aperture strip | |||
| Electron optics | Elstar ultra-high-resolution field emission SEM column | Elstar extreme high-resolution field emission SEM column | ||
| Magnetic immersion objective lens | Magnetic immersion objective lens | |||
| High-stability Schottky field emission gun to provide stable high-resolution analytical currents | High-stability Schottky field emission gun to provide stable high-resolution analytical currents | |||
| Electron beam resolution | At optimum working distance (WD) | 0.6 nm at 30 kV STEM 0.6 nm at 15 kV 1.0 nm at 1 kV 0.9 nm at 1 kV with beam deceleration* | 0.6 nm at 30 kV STEM 0.7 nm at 1 kV 1.0 nm at 500 V (ICD) | |
| At coincident point | 0.6 nm at 15 kV 1.5 nm at 1 kV with beam deceleration* and DBS* | 0.6 nm at 15 kV 1.2 nm at 1 kV | ||
| Electron beam parameter space | Electron beam current range | 0.8 pA to 176 nA | 0.8 pA to 100 nA | |
| Accelerating voltage range | 200 V – 30 kV | 350 V – 30 kV | ||
| Landing energy range | 20 eV – 30 keV | 20 eV – 30 keV | ||
| Maximum horizontal field width | 2.3 mm at 4 mm WD | 2.3 mm at 4 mm WD | ||
| Detectors | Elstar in-lens SE/BSE detector (TLD-SE, TLD-BSE) | |||
| Elstar in-column SE/BSE detector (ICD)* | ||||
| Elstar in-column BSE detector (MD)* | ||||
| Everhart-Thornley SE detector (ETD) | ||||
| IR camera for viewing sample/column | ||||
| High-performance in-chamber electron and ion detector (ICE) for secondary ions (SI) and electrons (SE)* | ||||
| Thermo Scientific In-chamber Nav-Cam Camera for sample navigation* | ||||
| Retractable, low-voltage, high-contrast, directional, solid-state backscatter electron detector (DBS)* | ||||
| Retractable STEM 3+ detector with BF/ DF/ HAADF segments* | ||||
| Integrated beam current measurement | ||||
| Stage and sample | Stage | Flexible 5-axis motorized stage | High-precision five-axis motorized stage with Piezo-driven XYR axis | |
| XY range | 110 mm | 150 mm | ||
| Z range | 65 mm | 10 mm | ||
| Rotation | 360° (endless) | 360° (endless) | ||
| Tilt range | -15° to +90° | -10° to +60° | ||
| Max sample height | Clearance 85 mm to eucentric point | Clearance 55 mm to eucentric point | ||
| Max sample weight | 500 g in any stage position Up to 5 kg at 0° tilt (some restrictions apply) | 500 g (including sample holder) | ||
| Max sample size | 110 mm with full rotation (larger samples possible with limited rotation) | 150 mm with full rotation (larger samples possible with limited rotation) | ||
| Compucentric rotation and tilt | Compucentric rotation and tilt | |||
* Available as an option, configuration dependent

Thermo Fisher Scientific PFA Demo Days
To support semiconductor manufacturing needs, Thermo Fisher Scientific continues to bring new capabilities to our industry-leading failure analysis, metrology and characterization solutions.
In our Thermo Fisher Scientific PFA Demo Days, we showcase our latest innovations for sample preparation and FinFET logic circuit delayering.

Introducing Helios 5 DualBeam
The new Thermo Scientific Helios 5 DualBeam builds on the high-performance imaging and analysis capabilities of the industry-leading Helios DualBeam family.
Register for our recorded webinar (~17 minutes) and learn how additional advancements to the new Helios 5 were designed to ensure the system is optimized for a variety of manual or automated workflows.
Latest application developments of multiple ion species plasma FIB technology
Register for our live webinar and learn how leading research labs are using our new Thermo Scientific Helios 5 Laser PFIB and Thermo Scientific Helios 5 Hydra DualBeam to advance their materials characterization.

Thermo Fisher Scientific PFA Demo Days
To support semiconductor manufacturing needs, Thermo Fisher Scientific continues to bring new capabilities to our industry-leading failure analysis, metrology and characterization solutions.
In our Thermo Fisher Scientific PFA Demo Days, we showcase our latest innovations for sample preparation and FinFET logic circuit delayering.

Introducing Helios 5 DualBeam
The new Thermo Scientific Helios 5 DualBeam builds on the high-performance imaging and analysis capabilities of the industry-leading Helios DualBeam family.
Register for our recorded webinar (~17 minutes) and learn how additional advancements to the new Helios 5 were designed to ensure the system is optimized for a variety of manual or automated workflows.
Latest application developments of multiple ion species plasma FIB technology
Register for our live webinar and learn how leading research labs are using our new Thermo Scientific Helios 5 Laser PFIB and Thermo Scientific Helios 5 Hydra DualBeam to advance their materials characterization.
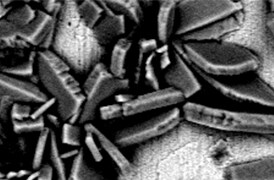
Controle de processo
A indústria moderna exige alta produtividade com qualidade superior, um equilíbrio mantido por meio de um controle de processo robusto. As ferramentas SEM e TEM com software de automação dedicado proporcionam informações rápidas e em várias escalas para monitoramento e aprimoramento de processos.

Controle de qualidade
O controle de qualidade e a garantia de qualidade são essenciais na indústria moderna. Oferecemos uma gama de ferramentas de microscopia eletrônica e espectroscopia para análises multidimensionais e multimodais de defeitos, permitindo que você tome decisões confiáveis e informadas para controle e melhoria de processos.

Pesquisa de materiais fundamentais
Novos materiais são investigados em escalas cada vez menores para o máximo controle de suas propriedades físicas e químicas. A microscopia eletrônica fornece aos pesquisadores percepções importantes sobre uma ampla variedade de características materiais em escala micro a nano.
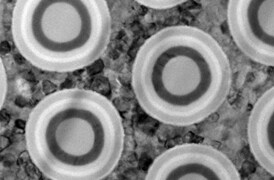
Desenvolvimento e localização de semicondutores
Microscopia eletrônica avançada, feixe de íon focalizado e técnicas analíticas associadas para identificar soluções viáveis e métodos de desenho para a fabricação de dispositivos semicondutores de alto desempenho.

Rampa de escoamento e metrologia
Oferecemos recursos analíticos avançados para análise de defeitos, metrologia e controle de processos projetados para ajudar a aumentar a produtividade e melhorar o rendimento em uma variedade de aplicações e dispositivos semicondutores.

Análise de falha de semicondutores
Estruturas de dispositivos semicondutores cada vez mais complexas resultam em mais locais onde defeitos que induzem falhas podem se ocultar. Nossos fluxos de trabalho de última geração o ajudam a localizar e caracterizar problemas elétricos sutis que afetam o rendimento, o desempenho e a confiabilidade.

Caracterização física e química
A demanda contínua dos consumidores impulsiona a criação de dispositivos eletrônicos menores, mais rápidos e mais baratos. Sua produção depende de instrumentos e fluxos de trabalho de alta produtividade que fazem imagens, analisam e caracterizam uma ampla gama de semicondutores e dispositivos de exibição.

Preparação de amostra (S)TEM
Os microscópios DualBeam permitem a preparação de amostras ultrafinas e de alta qualidade para análise de (S)TEM. Graças à automação avançada, os usuários com qualquer nível de experiência podem obter resultados de nível especializado para uma ampla gama de materiais.

Caracterização de materiais 3D
O desenvolvimento de materiais muitas vezes requer caracterização 3D em várias escalas. Os instrumentos DualBeam permitem a secção em série de grandes volumes e a subsequente geração de imagens SEM nanométricas, que podem ser processadas em reconstruções 3D de alta qualidade da amostra.

Prototipagem nanométrica
À medida que a tecnologia segue miniaturizando, a demanda por dispositivos e estruturas nanométricos aumenta cada vez mais. A nanoprototipagem 3D com instrumentos DualBeam ajuda a projetar, criar e inspecionar rapidamente protótipos funcionais micrométricos e nanométricos.

Preparação de amostra APT
A tomografia por sonda atômica (APT) fornece análise de composição de resolução atômica 3D de materiais. A microscopia de feixe de íons focalizados (FIB) é uma técnica essencial para a preparação de amostra de alta qualidade, orientada e específica de local para a caracterização APT.

Corte transversal
O corte transversal fornece dados adicionais ao revelar informações de subsuperfície. Os instrumentos DualBeam apresentam excelentes colunas de feixe de íons focalizados para corte transversal de alta qualidade. A automação permite realizar o processamento autônomo de amostras com alta produtividade.

Experimentação in situ
A observação direta e em tempo real de alterações microestruturais com a microscopia eletrônica é necessária para entender os princípios subjacentes de processos dinâmicos, como recristalização, crescimento de grãos e transformação de fases durante o aquecimento, o resfriamento e a umidificação.

Análise em várias escalas
Os materiais novos precisam ser analisados em resolução cada vez maior, mantendo o contexto maior da amostra. A análise em várias escalas permite correlacionar várias ferramentas e modalidades de geração de imagens, como a microTC de raios X, DualBeam, laser PFIB, SEM e TEM.
Edição de circuito
Soluções avançadas e dedicadas de edição de circuitos e nanoprototipagem, que combinam novos sistemas de distribuição de gás com um amplo portfólio de substâncias químicas e tecnologia de feixe de íons focalizados, oferecem controle e precisão incomparáveis para o desenvolvimento de dispositivos semicondutores.
Aquisição de imagens e análise TEM de semicondutores
Os microscópios eletrônicos de transmissão da Thermo Fisher Scientific oferecem imagens de alta resolução e análise de dispositivos semicondutores, permitindo que os fabricantes calibrem conjuntos de ferramentas, diagnostiquem mecanismos de falha e otimizem o rendimento geral do processo.
Preparação de amostra de dispositivos semicondutores
Os sistemas DualBeam da Thermo Scientific fornecem preparação precisa de amostra TEM para análise em escala atômica de dispositivos semicondutores. A automação e as tecnologias avançadas de aprendizado de máquina produzem amostras de alta qualidade, no local correto e com um baixo custo por amostra.
Análise e geração de imagens de semicondutores
A Thermo Fisher Scientific oferece microscópios eletrônicos de varredura para todas as funções de um laboratório de semicondutores, desde tarefas gerais de aquisição de imagens até técnicas avançadas de análise de falhas que exigem medições precisas de contraste de tensão.
Remoção de camadas de dispositivo
Reduzir o tamanho do recurso, juntamente com um desenho e arquitetura avançados, resulta em uma análise de falha cada vez mais desafiadora para semicondutores. A remoção de camadas sem danos aos dispositivos é uma técnica crítica para a detecção de defeitos e falhas elétricas ocultos.

Preparação de amostra (S)TEM
Os microscópios DualBeam permitem a preparação de amostras ultrafinas e de alta qualidade para análise de (S)TEM. Graças à automação avançada, os usuários com qualquer nível de experiência podem obter resultados de nível especializado para uma ampla gama de materiais.

Caracterização de materiais 3D
O desenvolvimento de materiais muitas vezes requer caracterização 3D em várias escalas. Os instrumentos DualBeam permitem a secção em série de grandes volumes e a subsequente geração de imagens SEM nanométricas, que podem ser processadas em reconstruções 3D de alta qualidade da amostra.

Prototipagem nanométrica
À medida que a tecnologia segue miniaturizando, a demanda por dispositivos e estruturas nanométricos aumenta cada vez mais. A nanoprototipagem 3D com instrumentos DualBeam ajuda a projetar, criar e inspecionar rapidamente protótipos funcionais micrométricos e nanométricos.

Preparação de amostra APT
A tomografia por sonda atômica (APT) fornece análise de composição de resolução atômica 3D de materiais. A microscopia de feixe de íons focalizados (FIB) é uma técnica essencial para a preparação de amostra de alta qualidade, orientada e específica de local para a caracterização APT.

Corte transversal
O corte transversal fornece dados adicionais ao revelar informações de subsuperfície. Os instrumentos DualBeam apresentam excelentes colunas de feixe de íons focalizados para corte transversal de alta qualidade. A automação permite realizar o processamento autônomo de amostras com alta produtividade.

Experimentação in situ
A observação direta e em tempo real de alterações microestruturais com a microscopia eletrônica é necessária para entender os princípios subjacentes de processos dinâmicos, como recristalização, crescimento de grãos e transformação de fases durante o aquecimento, o resfriamento e a umidificação.

Análise em várias escalas
Os materiais novos precisam ser analisados em resolução cada vez maior, mantendo o contexto maior da amostra. A análise em várias escalas permite correlacionar várias ferramentas e modalidades de geração de imagens, como a microTC de raios X, DualBeam, laser PFIB, SEM e TEM.
Edição de circuito
Soluções avançadas e dedicadas de edição de circuitos e nanoprototipagem, que combinam novos sistemas de distribuição de gás com um amplo portfólio de substâncias químicas e tecnologia de feixe de íons focalizados, oferecem controle e precisão incomparáveis para o desenvolvimento de dispositivos semicondutores.
Aquisição de imagens e análise TEM de semicondutores
Os microscópios eletrônicos de transmissão da Thermo Fisher Scientific oferecem imagens de alta resolução e análise de dispositivos semicondutores, permitindo que os fabricantes calibrem conjuntos de ferramentas, diagnostiquem mecanismos de falha e otimizem o rendimento geral do processo.
Preparação de amostra de dispositivos semicondutores
Os sistemas DualBeam da Thermo Scientific fornecem preparação precisa de amostra TEM para análise em escala atômica de dispositivos semicondutores. A automação e as tecnologias avançadas de aprendizado de máquina produzem amostras de alta qualidade, no local correto e com um baixo custo por amostra.
Análise e geração de imagens de semicondutores
A Thermo Fisher Scientific oferece microscópios eletrônicos de varredura para todas as funções de um laboratório de semicondutores, desde tarefas gerais de aquisição de imagens até técnicas avançadas de análise de falhas que exigem medições precisas de contraste de tensão.
Remoção de camadas de dispositivo
Reduzir o tamanho do recurso, juntamente com um desenho e arquitetura avançados, resulta em uma análise de falha cada vez mais desafiadora para semicondutores. A remoção de camadas sem danos aos dispositivos é uma técnica crítica para a detecção de defeitos e falhas elétricas ocultos.
Serviços de microscopia eletrônica para
a ciência dos materiais
Para garantir o desempenho ideal do sistema, fornecemos acesso a uma rede de especialistas em serviços de campo, suporte técnico e peças de reposição certificadas.


